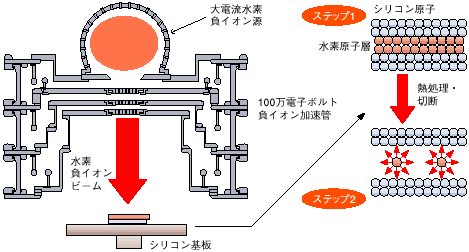 |
||
|
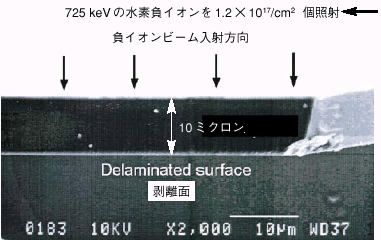 |
||
|
| 核融合プラズマの加熱用に開発した水素負イオンビームを用いて、次世代の超LSIや太陽電池用のシリコン基板を簡便に、大量に製作する技術を開発しました。
現在実用化されているシリコン基板の製作方法には、水素の正イオンビームをシリコン単結晶に一定の深さまで打ち込み、その後、600℃程度で熱処理すると、注入された水素がガス化して膨張し、シリコンが剥離する“水素注入デラミネーション法”があります。この方法では、水素の正イオンビーム中に多量の水素分子イオンや不純物金属イオンが混じります。このため、あらかじめ質量分離によりこれらを取り除く必要があり、製作速度やコストに難点がありました。
一方、核融合で開発した水素負イオンビームは、水素分子イオンや金属イオンを含みません。また、メートル級の大面積に数十アンペアの負イオンビームを発生させることができ、かつ、ビームエネルギーも100万電子ボルトに達しています。この新技術は、これまでの技術、すなわち最大エネルギーでも20万電子ボルトで、ミリアンペア級の正イオンをスポットビームでしか発生できなかった技術をはるかに凌駕するものです。 図2-19に負イオンビームを用いたシリコン薄膜切断の原理を示します。この負イオンビームを用いて得られた成果は、従来の製作速度に比べて100~1,000倍の製作速度を実現できる目途をつけたこと、また、これまで最大で2ミクロンの厚さのシリコン薄膜を、図2-20に示すように、10ミクロンの厚さまで製作することができるようになったことにあります。 この成果は、今後大きな需要が見込まれる単結晶シリコン薄膜を安価に製作することができ、また、効率のよい太陽電池の工業化などにも貢献できるものと期待されております。 |
| 参考文献
M. Hanada et al., Delamination of a Thin Silicon Layer by a High Energy H- Beam, Jpn. J. Appl. Phys. (2000) 発行予定. |
| ご覧になりたいトピックは左側の目次よりお選び下さい。 |
|
たゆまざる探究の軌跡-研究活動と成果2000 Copyright(c)日本原子力研究所 |