8-6 |
X線定在波現象を利用して多層膜X線ミラーの
|
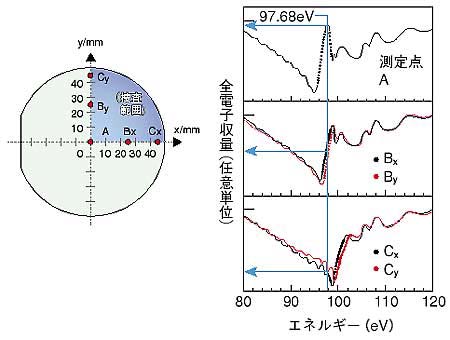 |
||
|
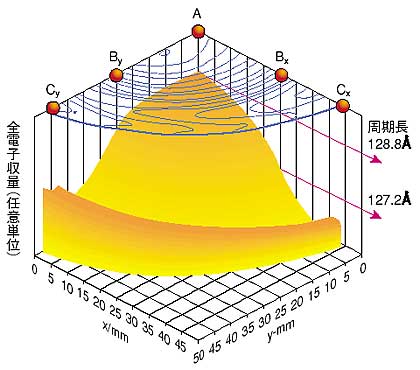 |
||
|
| 多層膜X線ミラーは高輝度なシンクロトロン放射光(以下、「放射光」と略します)やX線レーザ光の光学素子として利用されます。この多層膜X線ミラーは通常、直径が数インチの基板の上に、ナノメートルレベル(1ナノメートルは1ミリの百万分の1)の非常に薄い2種類の膜を交互に積み重ねてつくられます。多層膜X線ミラーの品質評価には、積み重ねた膜の厚さ(層構造)が基板面内で均一になっていることを確認することが重要ですが、電子顕微鏡などを使った従来の評価方法では多層膜試料を切断する必要があり、かつ迅速な評価がいささか難しいという問題がありました。 この問題を解決するため、私たちはX線定在波現象を利用した簡便な非破壊評価方法を提案しました。この方法では、単色化した放射光を多層膜X線ミラー試料に照射し、ここで生じる電流(全電子収量)を測定します。放射光のエネルギーが膜の厚さで決まる特定の値になるとX線定在波現象が起き、電流値が変化します(図8-13)。したがって、X線定在波現象が起きる特定の値に放射光のエネルギーを固定して、X線多層膜ミラー試料を水平方向と垂直方向に動かしながら照射位置と電流値の関係を求めれば、試料面内での層構造に関する情報を非破壊でとりだすことができます。すなわち、試料面をxy平面として電流値をz軸にとり作図すれば、試料面内での層構造の分布状況を三次元的に可視化表示することができます(図8-14)。この直径4インチのMo/Si多層膜X線ミラーを用いた実験から、1時間以内で測定できることがわかり、従来手法に比べて格段に速くかつ簡便に層構造分布を評価できることが示されました。今後、この評価方法が多層膜X線ミラーの開発プロセスに利用されることが期待されます。 |
| ●参考文献 Y. Muramatsu et al., Total-Electron-Yield X-Ray Standing-Wave Measurements of Multilayer X-Ray Mirrors for Interface Structure Evaluation, Jpn. J. Appl. Phys., 41, 4250 (2002). |
| ご覧になりたいトピックは左側の目次よりお選びください。 |  |
| たゆまざる探究の軌跡-研究活動と成果2002 Copyright(c) 日本原子力研究所 |