6-1 |
放射線が引き金となる光半導体の電流増幅異常を追及 |
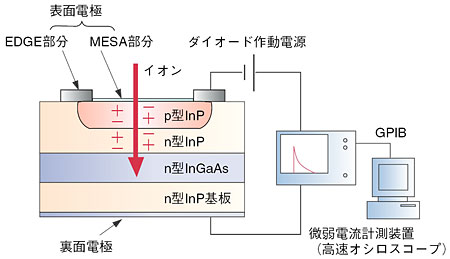 |
||
|
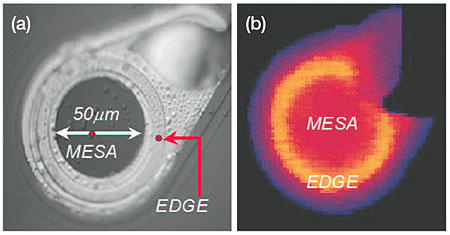 |
||
|
| 光の発信・受信を介して高速で動作する光半導体は、現在の高速大容量通信や高精密制御に不可欠な電子部品です。このような光半導体の応用領域は拡がりつつあり、近年では航空機や人工衛星などにも搭載され、放射線レベルが高い環境でも使用されるようになってきました。半導体に放射線が当たると劣化や誤動作が起こります。 宇宙での半導体利用については以前から放射線影響が問題視されていますが、最近では半導体の極微細化に伴いノイズマージンが低下し、地上でも誤動作が発生するなどの問題が出始めており、発生原因の解明が強く求められています。 私たちは、放射線による半導体の誤動作、いわゆるシングルイベント現象の発生要因究明の一環として、TIARAを利用して、放射線で引き起こされる光半導体の動作異常を調べてきました。 実験では、イオン1個で半導体素子に誘起される微弱電流を二次元でかつ時間分解して観察できるTIBIC(Transient Ion Beam Induced Current)システムを開発して、計測を行いました。高速InP/InGaAs光ダイオードのイオン誘起電流を計測して異常発生と素子構造との相関を調べたところ(図6-1)、素子中央部(MESA)より端部(EDGE)で極めて高い異常電流が発生することを初めて見出すことができました(図6-2)。さらにその原因を追求した結果、素子端部に加わった高電界によるなだれ増倍(イオンで発生した電荷が引き金となり、高電界中で次々に電荷が増倍する現象)に起因することを突き止めました。 これらのことから、光ダイオードの耐放射線性の強化には、光ダイオード端部の構造を最適化し、電界強度を低下させる必要があるとの技術的見通しが得られました。 |
| ●参考文献 J. S. Laird et al., Heavy-Ion Induced Single-Event Transients in High-Speed InP-InGaAs Avalanche Photodiodes, IEEE Trans. Nucl. Sci., 50(6), 2225 (2003). |
| ご覧になりたいトピックは左側の目次よりお選びください。 |  |
| たゆまざる探究の軌跡−研究活動と成果2004
Copyright(c) 日本原子力研究所 |