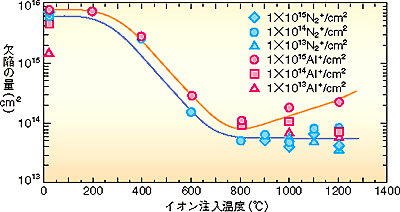 |
|||
|
|||
|
(a)SiC-MOS(金属/酸化膜/半導体)トランジスタの作製
(b)SiC-MOSトランジスタの拡大写真 |
|||
|
|||
原子力や宇宙の放射線環境で使用される半導体素子の開発には、放射線に弱いシリコンに替わる半導体材料が必要です。原研では高出力、高温、および、優れた耐放射線性が期待できる炭化ケイ素(SiC)結晶を基板とした半導体素子の開発を行ってきました。
SiCトランジスタを作るには結晶中にイオン注入などで不純物を導入し、p型やn型のSiC結晶を作る必要があります。しかし、SiC結晶では通常の方法でイオン注入しても不純物が電気的に活性化しないので、高温イオン注入に着目し、1,000
℃に加熱したp型SiC単結晶基板にn型不純物である窒素イオンを注入しました。すると、注入による欠陥が大幅に減少し(図4-5)、注入した窒素が電気的に活性化してp型SiCをn型SiCに変えることがわかりました。また、トランジスタの集積化に不可欠なMOS(金属/酸化膜/半導体)構造については、水素を燃焼して作った純粋な水蒸気と酸素の混合気体を用いて、1,100
℃に加熱したSiC基板の表面を酸化(絶縁膜)することで、シリコンより2桁強い耐放射線性をもつMOS構造を作製することができました。
これらの高温イオン注入技術とSiC-MOS技術を用いて、耐放射線性に非常に優れたSiC-MOSトランジスタを作製することに成功しました(図4-6)。SiCはシリコンの2倍の電子移動速度を持つため高速・高集積度のLSIが可能であり、また、高温、高電圧・大電流でも使えるため、自動車、電力送電システムなどへの利用にも熱い期待が寄せられています。
参考文献
H. Itoh et al., Characterization of Residual Defects in Cubic Silicon Carbide Subjected to Hot-Implantation and Subsequent Annealing, J. Appl. Phys., 82 (11), 5339 (1997).
| ご覧になりたいトピックは左側の目次よりお選び下さい。 |
|
たゆまざる探究の軌跡-研究活動と成果1998 copyright(c)日本原子力研究所 |