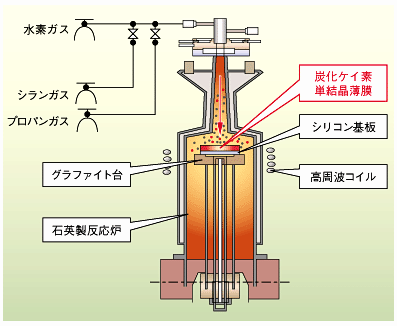 |
||
|
 |
||
|
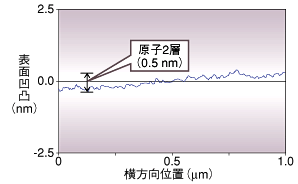 |
||
|
| 人工衛星用の新しい太陽電池や半導体メモリー素子材料として、シリコンに比べ耐放射線性が高く、より高温で使用できる炭化ケイ素単結晶の研究が行われています。しかし、炭化ケイ素はシリコンと比較して共有結合性が強く、また、いろいろな結晶形態があるので単一結晶構造で欠陥の少ない大きな単結晶を作製することが極めて難しい材料でした。 原研では半導体材料として使用できるほどの大面積・高品質の立方晶炭化ケイ素単結晶(3C-SiC)薄膜をシリコン基板上に作製することに成功しました。3C-SiC単結晶は原料であるシランガス(SiH4)とプロパンガス(C3H8)を水素ガス(H2)と混合して、1,300℃に加熱したシリコン基板表面に吹きつけ、化学気相法(図6-8)で単結晶を成長させます。原研では原料ガスや水素の混合比、原料ガスのシリコン基板に対する流速、シリコン基板温度をいろいろ変化させて研究を進めた結果、従来とはかなり異なった条件、すなわち水素ガスの割合を大幅に少なくした原料ガスを用い、ガス流速を速くしてシリコン基板上に吹きつけることによって、これまで困難とされていた大面積・高品質の単結晶薄膜(図6-9)を再現性よく成長させる方法を見いだしました。これは、原料ガス中のシラン分子が熱分解する前にシリコン基板表面に到達して分解・反応することで、欠陥の少ない表面の平滑な炭化ケイ素単結晶薄膜が生成すると考えられます(図6-10)。この単結晶とイオン注入技術や酸化膜作製技術を組み合わせて、原子力や宇宙のような過酷な環境で使用される半導体集積回路の実現を目指しています。 |
| 参考文献
M. Yoshikawa et al., Growth of 3C-SiC by Low Pressure Chemical Vapor Deposition with Vertical Reactor, Thin Solid Films (1999) 掲載予定. |
| ご覧になりたいトピックは左側の目次よりお選び下さい。 |
|
たゆまざる探究の軌跡-研究活動と成果1999 copyright(c)日本原子力研究所 |