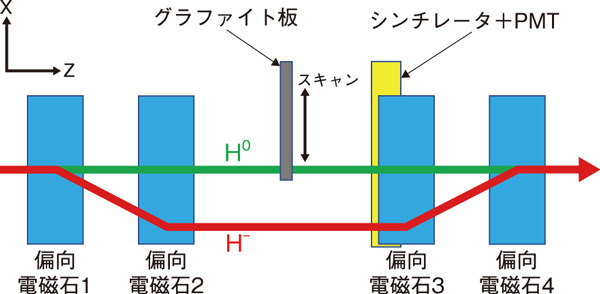
図1 MEBT2に設置したH0粒子診断系

図2 検出されたPMT信号の例
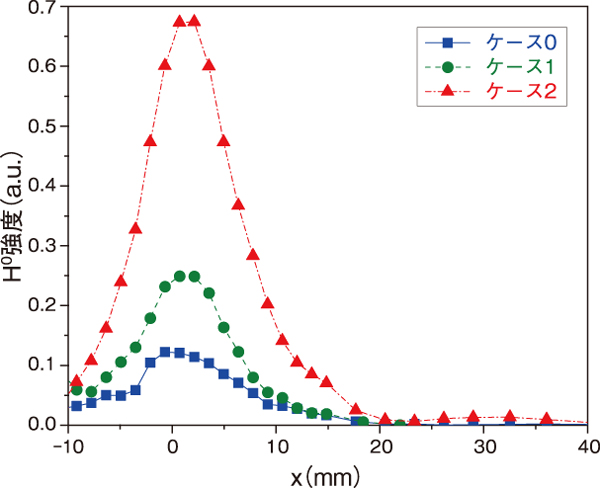
図3 MEBT2で測定されたH0粒子のx方向強度分布
大強度ビーム加速に伴うビーム損失は、たとえそれがほんのわずかなものであっても、加速器機器の放射化を引き起こします。そのため、作業者の被ばく低減等の観点で、ビーム損失は大強度加速器における重要な課題となっています。J-PARCリニアックでは、大強度の負水素イオン(H−)ビームを機能分離型ドリフトチューブリニアック(SDTL)で191 MeVまで加速した後、環結合型リニアック(ACS)で400 MeVまで加速しています。加速途中のH−は主に次のような原因で電子を失い(電子ストリッピング現象)、制御不能な水素原子(H0)になるためビーム損失を引き起こします。
・H−ビームとビームライン上の残留ガスとの衝突に起因する残留ガスストリッピング
・高周波バンチ内でのH−イオン同士の衝突に起因する高周波バンチストリッピング
・外からの電場・磁場に起因するフィールドストリッピング
これらは負イオンリニアックに特徴的なビーム損失要因であり、ビーム損失の低減にはその詳細な調査が不可欠となりますが、その方法が確立していませんでした。
そこで私たちは、電子ストリッピングに起因するビーム損失要因を調べるため、SDTLとACSの間の第2中エネルギービーム輸送部(MEBT2)に専用のH0粒子診断系を設置し(図1)、H0粒子の相対強度を測定しました。この診断系では、ビームライン上のH0粒子をH−ビームから分離し、グラファイト板に衝突させて得られる二次放射線をシンチレータと光電子増倍管(PMT)で検出します。MEBT2の上流側にあるSDTL部の残留ガス量を変化させてPMT信号を測定すれば、ガスストリッピングによるH0粒子の発生分のみを評価できます。検出されたPMT信号の例を図2に、測定したH0粒子の水平(x)方向強度分布を図3に示します。解析の結果、通常運転状態においてMEBT2で検出されたH0粒子の約半分は、SDTL部の残留ガスストリッピングで生成されたものであることが分かりました。残りのH0粒子については、電子ストリッピング断面積を用いた計算により、主に高周波バンチストリッピングによって発生したものと推定されました。一方ACS部では、残留ガス圧力がSDTL部より一桁低いため、電子ストリッピング損失は主に高周波バンチストリッピングに起因することが分かりました。
本研究は、SDTLセクションの残留圧力をさらに改善することが、ビーム損失軽減のために有効であることを示すものです。
(田村 潤)