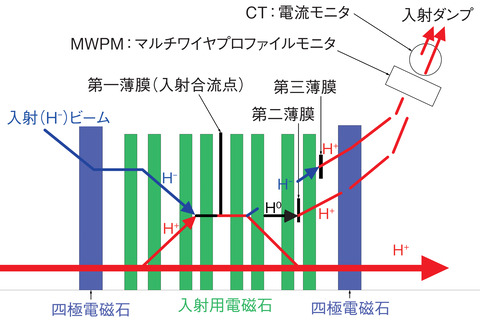
図5-2 3 GeVシンクロトロンの荷電変換入射方式概念図

図5-3 ダンプに廃棄された割合と薄膜の厚みの履歴
大強度陽子加速器施設(J-PARC)の3 GeVシンクロトロンでは、リニアックで加速した負水素(H-)ビームを入射する際に、炭素薄膜を通し陽子(H+)に変換して、周回している陽子ビームに重ねて入射します(図5-2)。この手法を荷電変換入射と呼びます。この入射方式によって、ビームサイズを広げずに大電流ビームを蓄積することができますが、安定運転のためには入射のたびにビームが照射される炭素薄膜の劣化状態を把握する必要があります。本方式では、炭素薄膜で電子をはぎ取れなかった中性水素原子(H0)やH-が一定量存在し、それが入射部周辺で失われた場合に放射化を引き起こすため、再度炭素薄膜を通過させ陽子に変換した上で入射ダンプに導いて廃棄しています。
私たちは、この入射ダンプへのビーム輸送ライン中に電流モニタ(CT)及びマルチワイヤプロファイルモニタ(MWPM)を設置し、ダンプへ輸送されるH0とH-の量を測定することで、炭素薄膜の劣化状態を監視する手法を開発しました。薄膜に異常がなければ、入射ビームのほとんどは陽子に変換されるため、H0とH-の量は非常に少なくなります。そのためCTで観測される信号強度は非常に小さくなり、精度良い測定は難しくなります。そこで私たちは、入射(H-)ビームが0.81マイクロ秒ごとに塊(パルス)として入射されていることに着目し、CT信号の高速フーリエ変換(FFT)処理を行い、その時間構造に対応した周波数である1.23 MHzのピークを取り出して解析することで、高い測定精度を実現しました。CTでの測定は、ビームに影響を与えないため、運転中連続に行うことができ、入射に失敗した粒子量の連続的な変化を測定できます。またMWPMを導入することで、入射ダンプ輸送ライン上で異なる軌道を通るH0とH-の存在量の相対的な比を得ることを可能にしました。MWPMで測定したデータのうちH0の存在量は、ほぼ薄膜の厚みによって決まります。一方H-の存在量は、薄膜で電子がはぎ取られなかった場合以外に、入射ビームが薄膜の大きさより広がっていて、薄膜と衝突しなかった場合にも増えます。そのため、CTの連続測定で得られたダンプに廃棄されるビーム量のうち、入射ビームの状態変化によるビーム量と、薄膜の状態が変化したことによるビーム量とを、MWPMの測定と合わせることで切り分けることができます。最終的に、この薄膜の状態変化に起因するビーム量から、測定時の薄膜の厚みを決めることができます。上記手法により評価した、ダンプに廃棄されたビームの割合、及び変換効率から導出した薄膜の厚さの測定結果を図5-3に示します。
これまでは、運転中に膜の厚さを測定する手法は存在しませんでしたが、本研究開発によって運転中の薄膜を使用しながら、膜厚変化を測定することが可能となりました。このシステムによって、2年間にわたって薄膜の測定を行うことで、薄膜の経時変化を定量的に評価し、長期間連続使用可能であることを確かめました。このような薄膜の状態変化と寿命に関する貴重なデータを、世界で初めて取得することに成功しました。
(Saha Pranab Kumar)